BGA返修工艺流程
1、一、拆焊
1、按照国际惯例,第一步我们要先给PCB板和BGA进行预热,去除PCB板和BGA内部的潮气。可使用恒温烘箱进行烘烤。
2、选择适合BGA芯片大小的风嘴并安装到机器上,上部风嘴要完全罩住BGA芯片或者稍微大1~2mm为合适。上部风嘴可以大过BGA,但是绝对不能小于BGA,否则可能导致BGA受热不均。下部风嘴则选用大于BGA的风嘴即可。
3、将有问题的PCB板固定在BGA返修台上。调整位置,用夹具夹住PCB并使BGA下部风嘴(不规则的PCB板可使用异形夹具)。插入测温线,调整上下部风嘴的位置,使上部风嘴覆盖BGA并与BGA保持约1mm的距离,下部风嘴顶住PCB板。
4、设定对应的温度曲线,有铅熔点183℃,无铅丽喝熔点217℃。可根据返修台内部自带的无铅标准温度曲线来使用并进行适当调整,如图。(下图是我个人返修时设置的参数,仅供参考。这里也建议使用可以直接通过程序设定温度曲线的BGA返修台,这样操作比较简便,温度方面也可以实时监测,方便调整)
如无法拆下,再根据实际返修所遇到的情况进行适当调试。
1、点击拆焊,待机器报警时移开上部风头,并使用机器自带的真空吸笔吸起BGA。

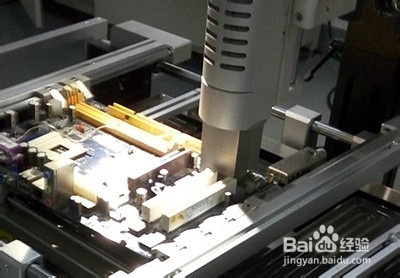

2、二、返修BGA
1、清理焊盘:如果BGA刚拆下,最好在最短的时间内清理PCB和BGA的焊盘,因为此时PCB板与BGA未完全冷却,温差对焊盘的损伤较小。步骤如下
1) 将设定烙铁的温度,370℃(无铅),320℃(有铅);
2) 用笔刷在BGA焊盘上均匀抹上助焊膏;
3) 用烙铁将焊盘上残留的锡拖干净,再使用吸锡线辅以烙铁拖平焊盘,保证焊盘上平整、干净;
4) 清洗焊盘,使用一些挥发性较强的溶剂,如洗板水、工业酒精对焊盘进行擦洗,清除残留在焊盘上的锡膏。
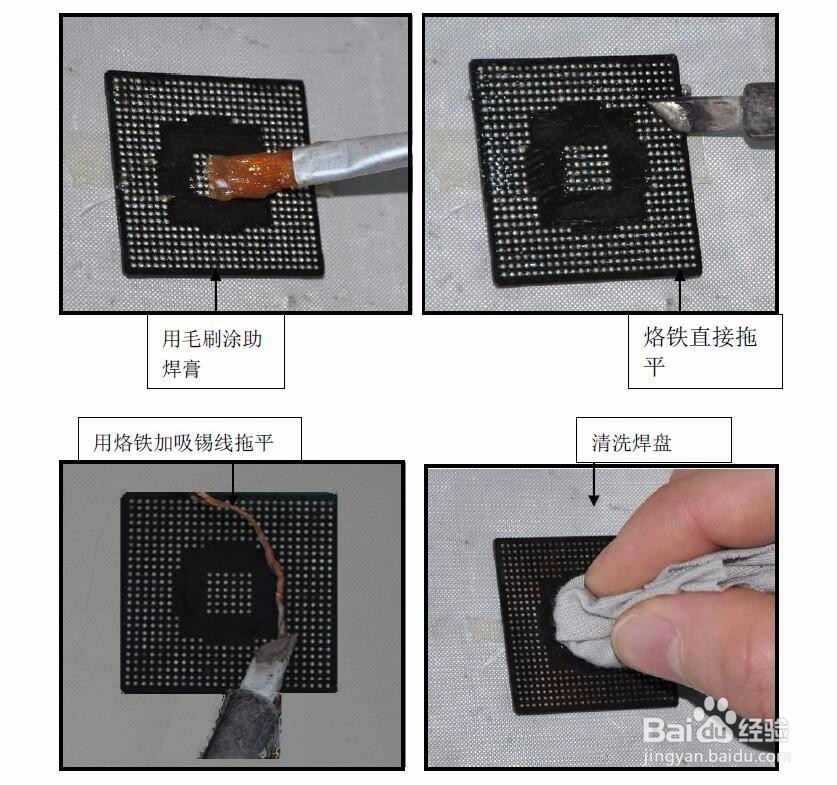
3、BGA植球(这一步如果不使用植球台而是要一颗颗摆的话,只能说你开心就好了):此处需要使用植球台、对应大小的锡球、与BGA匹配的钢网。
1) 将BGA固定在植球台正中间,可参考对角线,然后锁紧定位块;
2) 选择与BGA相应的钢网,匹配好后将其锁紧在植球台定位框;
3) 用笔刷在BGA上均匀涂抹助焊膏,然后把定位框装上,调整BGA焊盘与植球台钢网之间的高度差,确保每个钢网孔只能漏进一颗锡球;
4) 往钢网上撒入适量的对应型号的锡球,轻轻晃动植球台,让每个钢网孔都能漏进锡球检查无漏植的锡珠后,倾斜植球台将多余的锡球倾向一边再取走植球台定位框(注意倾斜放置以免锡珠从钢网小孔滚出),再取走植株台。
5) 将完成的BGA取下(如果在这时检查有漏植锡珠的BGA时,可用大小适中的镊子将锡珠补上)。
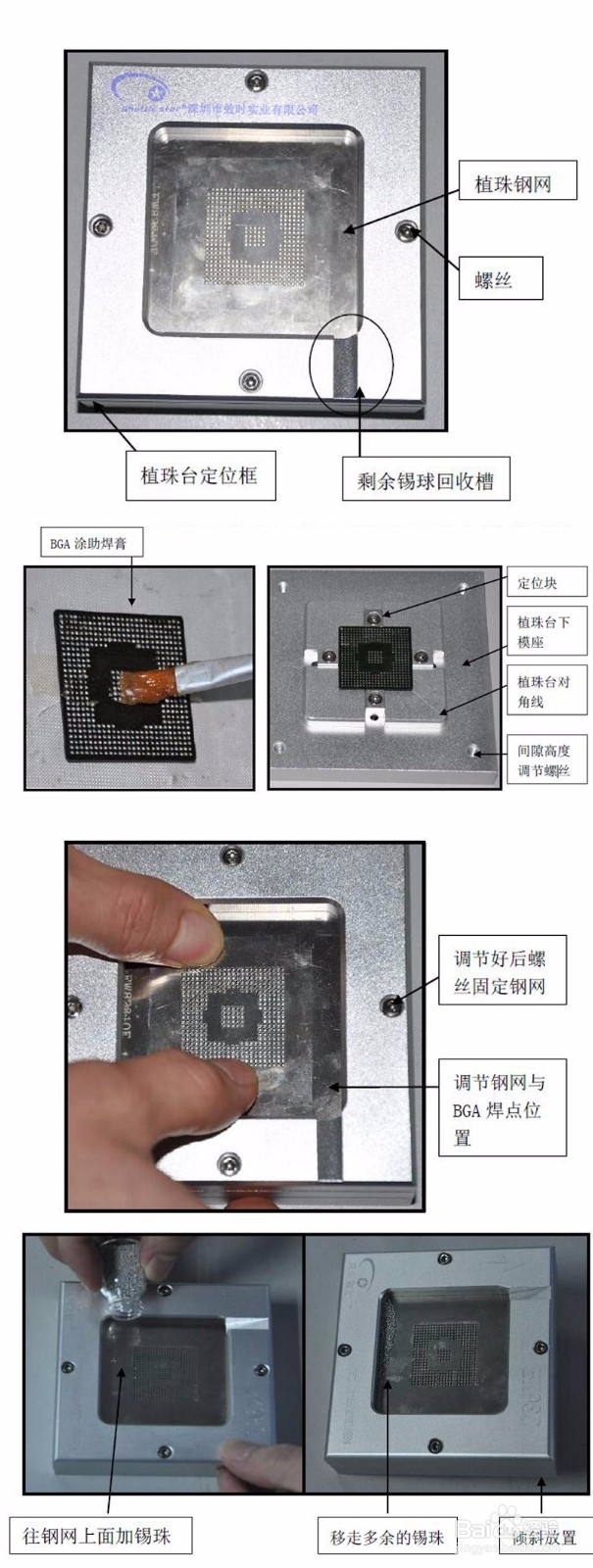
4、BGA锡球焊接:设置加热台的焊接温度(有铅约230℃,无铅约250℃),将植珠完的BGA放在加热台焊接区的高温布上,并使用热风筒进行加热。待BGA的锡球处于熔融状态,且表面光亮,有明显液态感,锡球排列整齐,此时将BGA移至散热台,让其哄鬼冷却,焊接完成。
三、重新焊接
1、涂抹助焊膏:为保证焊接质量,涂助焊膏前先检查PCB焊盘上有无灰尘,最好在 每次刷涂助焊膏前都擦一下焊盘。将PCB放置在工作台上用毛刷在焊盘位置涂上适量一层助焊膏,(涂过多会造成短路,反之,则容易空焊,所以焊膏涂布一定要均匀适量,以去除BGA锡球上的灰尘杂质,增强焊接效果)。
2、贴装:将BGA对正贴装在PCB上;以丝印框线作为辅助对位,将BGA焊盘与PCB板焊盘基本重合,注意BGA表面上的方向标志应与PCB板丝印框线方向标志对应,防止BGA放反方向。在锡球融化焊接的同时,焊点之间的张力会产生一定的自对中效果。
3、焊接:该步骤同拆焊步骤。将PCB板放置在BGA返修台上,确保BGA与PCB之间对接无偏差。应用拆焊的温度曲线,点击焊接。待加热结束,自动冷却后即可取下,欧叮哨返修完成。
